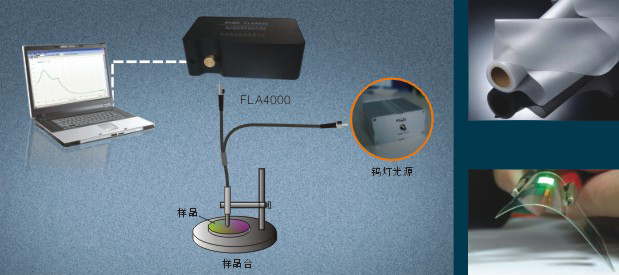
方案介紹:
附著在基底上的薄膜表面進(jìn)行反射測(cè)試時(shí),會(huì)出現(xiàn)一副干涉條紋的圖樣,配置合適的測(cè)試方案,通過特定測(cè)試軟件,可以計(jì)算出薄膜的厚度。
薄膜測(cè)量系統(tǒng)是基于白光干涉的原理來確定光學(xué)薄膜的厚度。測(cè)試得到白光干涉圖樣后,再進(jìn)行數(shù)學(xué)運(yùn)算計(jì)算出薄膜厚度。
對(duì)于單一類型的膜層來說,如果已知薄膜的n和k值就可以計(jì)算出它的物理厚度。
將光纖光譜儀與光纖探頭在生產(chǎn)線上構(gòu)建實(shí)時(shí)測(cè)量系統(tǒng),可為高精度工件加工線上質(zhì)量監(jiān)測(cè)和工業(yè)鍍膜過程提供了一種靈活方便的測(cè)量手段。
薄膜測(cè)量主要應(yīng)用于半導(dǎo)體晶圓工業(yè),此時(shí)需要監(jiān)控等離子刻蝕和沉積過程,還可以用于其它在金屬和玻璃基底上鍍制透明膜層的測(cè)量領(lǐng)域。